電子機器開発者のための半導体パッケージ熱設計入門 ――待ったなし!SOC & SIPの熱対策
● パッケージの熱抵抗を決める五つの要因
チップ表面から環境雰囲気までの熱抵抗値θjaを決めているおもな要因は次のとおりです.
1) パッケージ構造
ASIC用のパッケージにはQFP,PBGA(plastic BGA,図4),FBGA(fine pitch BGA,図5),TBGA(tape BGA,図6),ABGA(advanced BGA,図7),FCBGA(flip-chip BGA,図8)などがあります.それぞれのパッケージの熱抵抗θjaとθjcを図9に示します.パッケージの上面プレートが銅板製で,チップが直接伝熱ペーストで接着されたABGAやFCBGAなどは上面への熱伝導が良好で,接合部とパッケージ表面の間の熱抵抗θjcも,接合部から雰囲気温度までの熱抵抗θjaも良好な値になっています.また,PBGAでは2層配線基板よりも4層配線基板のほうが熱抵抗が低く,サーマル・ビアの直下にはんだボールを配置することによって,さらに熱抵抗を下げることができます.

(a)チップ表面

(b)チップ裏面
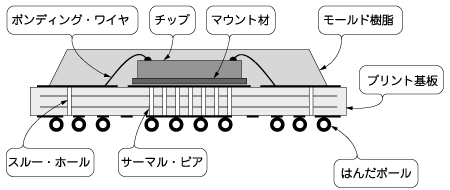
(c)チップ断面図
図4 PBGA
PBGAは,両面または4層のプリント基板上に半導体チップを搭載してワイヤ・ボンディングし,樹脂によって封止した後,チップ搭載面の反対側にはんだボールを配置したパッケージ(キャビティ・アップ).熱抵抗を下げるため,チップの直下にはんだボールを配置してスルー・ホールで熱の通り道を設けている.また,パッケージ基板には4層基板やメタルコア基板を用いて,熱抵抗を下げている.
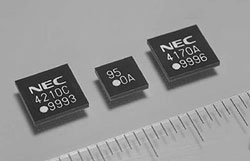
(a)チップ外観

(b)チップ断面図
図5 FBGA
FBGAは,はんだボール・ピッチが1mm未満のPBGAを指す.数量ベースでもっとも多く使われているパッケージ.

(a)チップ表面

(b)チップ裏面
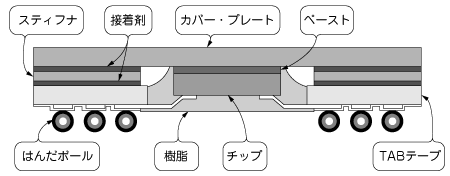
(c)チップ断面図
図6 TBGA
TAB(tape automated bonding)技術で半導体チップをボンディングしたテープ基板のBGA.ボール・ピッチは1mm~1.27mm,ボール数は256~868個.

(a)チップ表面

(b)チップ裏面
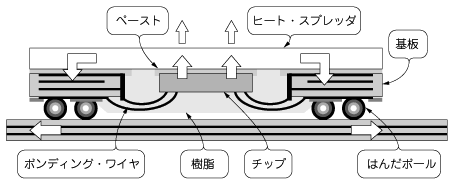
(c)チップ断面図
図7 ABGA
ABGAは,多層基板に銅板のヒート・スプレッダが貼り付けられ,チップが中央のキャビティに搭載されたパッケージ(キャビティ・ダウン).半導体メーカごとに名まえが異なっており,SBGA(Super BGA),EBGA(Enhanced BGA)とも呼ばれている.ボール・ピッチは1mm~1.27mm,ボール数は256~1,008個.熱流は熱伝導率の高い銅板を通ってパッケージ表面に出るが,雰囲気へ放熱(熱伝達)されるのはその一部で,残りはプリント基板側へ熱伝導される.
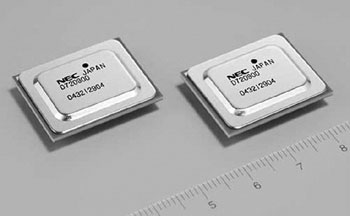
(a)チップ外観

(b)チップ断面図
図8 FCBGA
高密度配線のビルドアップ基板にチップを下向けにはんだボール接続したBGA.ボール数は624~2,803個.
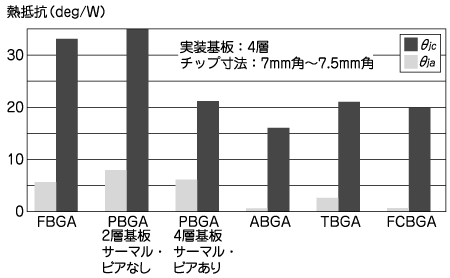
図9 パッケージ構造による熱抵抗の違い
パッケージの上面プレートが銅板製で,チップが直接伝熱ペーストで接着されたABGAやFCBGAなどは上面への熱伝導が良好である.


