電子機器開発者のための半導体パッケージ熱設計入門 ――待ったなし!SOC & SIPの熱対策
2) パッケージ寸法
一般に,パッケージ寸法が大きいほど熱抵抗は低いと言われています.実際,パッケージの熱抵抗qjcの低いABGAでは,図10に示すようにパッケージ寸法が大きいほど熱抵抗は小さくなっています.
ところが,2層のパッケージ基板を採用したPBGAやFBGAでは,図11に示すようにパッケージ寸法との相関が見られず,チップ寸法が同じであれば同一の熱抵抗値を示しています.これは,2層パッケージ基板を採用しているPBGAの伝熱面積が小さい(チップ直下のみが熱くなっている)ため,パッケージの外形が大きくなってもプリント基板上の温度プロファイルは変化していないと理解できます.
それに対して,ABGAの場合,パッケージ表面の銅板を通って熱がパッケージ全面に拡散するため,プリント基板上の温度プロファイルはパッケージ寸法に比例して熱伝達面積が大きくなったと考えられます.
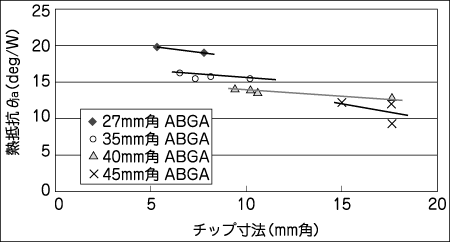
図10 ABGAのパッケージ寸法と熱抵抗
伝熱面積の大きなABGAはパッケージ寸法が大きくなることによって,より広範囲に放熱範囲を広げられる.
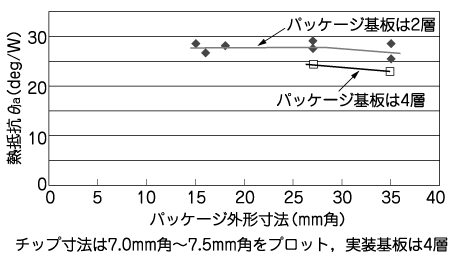
図11 PBGA,FBGAのパッケージ寸法と熱抵抗
伝熱面積の小さな2層基板のPBGAの場合,プリント基板上の温度プロファイルはFBGAとほぼ等しく,パッケージ寸法は熱抵抗にほとんど影響していない.


