電子機器開発者のための半導体パッケージ熱設計入門 ――待ったなし!SOC & SIPの熱対策
● QFPの熱抵抗はこうやって下げる
QFPについて,材料,リード・フレーム,パッケージ構造の三つの観点から熱抵抗を下げる方法を紹介します.
1) 開発余地のある高熱伝導樹脂
QFPの場合,図15に示すように材料の観点からはモールド樹脂がもっとも熱伝導率が低く,0.8~0.9W/m・degとなっており,高熱伝導化することが考えられます.その手法としては,「樹脂に充てんするフィラーの率を増加する」,「高伝導率フィラーに変更する」などの方法が考えられます.
前者については,外部リードのメッキを鉛フリー化するために,実装時のリフロ温度を上げる必要があり,そのリフロに耐えられる樹脂にするために,現在,90%程度までフィラー充てん率を高くしています.言い換えれば,モールド樹脂といっても樹脂成分は10%しかなく,主成分は溶融シリカと呼ばれる球状の微細ガラスなのです.この溶融シリカの熱伝導率は1.3W/m・degなので,より熱伝導率の高いアルミナ(36W/m・deg)などや,セラミックを破砕したフィラーに変更することによって,モールド樹脂の熱抵抗を下げることができます.
モールド樹脂は半導体の信頼性の要なので,熱伝導率だけで材料を選定することはできません.しかし,今後,消費電力の増大に伴って高熱伝導樹脂への要求が高まることは確実です.また,チップ上の樹脂厚を薄くすることによって伝熱距離が短くなり,熱抵抗θjaが低くなります.そのため,ヒート・シンクを表面に取り付けて放熱する際は,QFPよりも樹脂厚の薄いTQFPのほうがヒート・シンクによる放熱の効果は大きくなります.
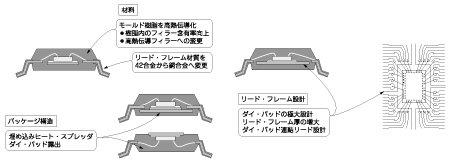
図15 QFPの低熱抵抗設計
QFPについて,材料,リード・フレーム,パッケージ構造の三つの観点から熱抵抗を下げる方法を示した


