電子機器開発者のための半導体パッケージ熱設計入門 ――待ったなし!SOC & SIPの熱対策
3) チップ寸法
シリコンの熱伝導率は117.5W/m・degとモールド樹脂の100倍,パッケージ基板の10倍です.つまり,チップ自体の表面積は熱伝導に大きく寄与しており,チップ面積と熱抵抗θjaはほぼ反比例します(図12).また図13に示すように,接合部とパッケージの間の熱抵抗θjcもチップ面積に反比例しています.これは,モールド樹脂やパッケージ基板などの絶縁物に囲まれている中で,チップ面積がもっとも放熱に寄与しているからです.
ちなみに,FBGAのθjcのほうがPBGAよりも小さな値となっていますが,これはチップ表面のモールド樹脂厚がFBGAはPBGAの半分以下と薄いために熱経路長が短くなったからです.パッケージ表面にヒート・シンクやヒート・スプレッダを貼り付けて熱抵抗を下げるときは,θjcが低いほど効果があります.ですので,この場合はPBGAよりもチップ上のパッケージ厚が薄いFBGAのほうが放熱が良好であることがわかります.
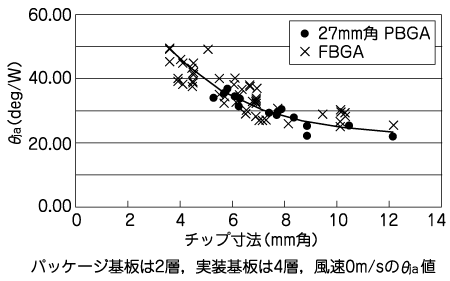
図12 PBGA,FBGA外形とチップ寸法によるθjaの変化
チップ面積と熱抵抗θjaはほぼ反比例する.

図13 PBGAとFBGAのθjc
熱抵抗θjaと同様に,接合部とパッケージの間の熱抵抗θjcもチップ面積に反比例する.FBGAはPBGAよりも樹脂厚が薄いのでθjcが低い.


