電子機器開発者のための半導体パッケージ熱設計入門 ――待ったなし!SOC & SIPの熱対策
● BGAの熱抵抗はこうやって下げる
BGAの場合も,図16に示すように材料,基板設計,パッケージ構造によって伝熱面積を大きくする低熱抵抗化の施策があります.
1) コストアップの少ないサーマル・ボールを付ける
パッケージ構造の観点からは,まずチップ裏面にはんだボールを多数設け,はんだボールとダイ・パッドを熱的に結ぶスルー・ホール(サーマル・ビア)を設けることによって,チップ裏面から直下のはんだボールまでの熱的な経路を作ります.これらのパッケージ中央のボールは,電気的にはグラウンドの役割,熱的には実装基板への熱伝導の役割を担っています.そのため,これらのボールは一般に「サーマル・ボール」と呼ばれます.
低熱抵抗化の施策の中ではこの方法がもっとも安価です.サーマル・ボールがグラウンド端子も兼ねているので,周辺のボールは信号ピンとして割り当てられ,実質的な端子数は増加します.
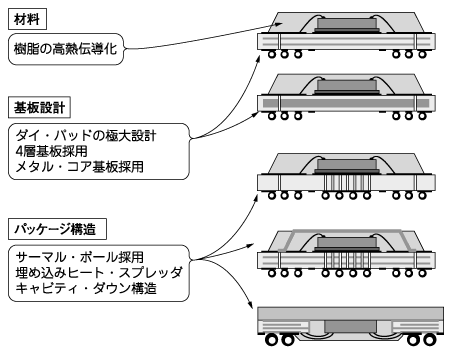
図16 BGAの低熱抵抗設計
BGAについて,材料,基板設計,パッケージ構造の三つの観点から伝熱面積を大きくする低熱抵抗化施策を示した.


