電子機器開発者のための半導体パッケージ熱設計入門 ――待ったなし!SOC & SIPの熱対策
2. パッケージの放熱経路
次に,半導体パッケージの放熱の基礎について説明し ます.
図1に示すように,パッケージからの放熱には次の3種類があります.
- 固体内の熱量の移動である熱伝導
- 固体から流体への熱量の移動である対流(熱伝達)
- 電磁波によって熱を放射する熱放射
接続部(junction)から雰囲気に向かって流れる熱流の経路に応じて,各部の熱抵抗を図2のように細分化します.これらの熱抵抗を電気回路図と同じように表現したのが図3です.図3に示すように,放熱経路は大きく分けて,
- パッケージの表面トップから大気に対流熱伝達する経路
- 外部端子からプリント基板に熱伝導して,プリント基板から大気に対流熱伝達する経路
- パッケージ側面への放熱(無視できるほど小さい放熱)
の三つがあります.これら三つの経路の熱量の比率は,それぞれの経路の抵抗値に反比例します.これらのパラメータのうち,チップからパッケージ表面までの熱抵抗θjc,パッケージ側面への熱抵抗θjs,ボールのランドからプリント基板表面への熱抵抗θbpは,固体内の熱量の移動なので熱伝導に対する抵抗値です.また,パッケージ表面から雰囲気への熱抵抗θcaとプリント基板から雰囲気への熱抵抗θpaは,固体から流体への熱量の移動である熱伝達と熱放射に対する抵抗値です.
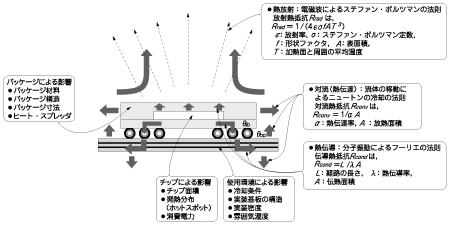
図1 放熱経路と熱抵抗の要因(1)
パッケージからの放熱には,体内の熱量の移動である熱伝導,固体から流体への熱量の移動である対流(熱伝達),電磁波によって熱を放射する熱放射の3種類がある.

図2 熱流の経路
接続部から雰囲気に向かって流れる熱流の経路に応じて熱抵抗を細分化した図.PBGA(plastic BGA)の例を示した.
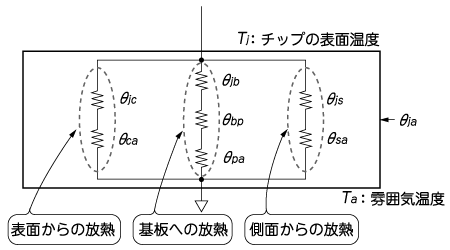
図3 熱等価回路
接合部から雰囲気までの熱抵抗であるθjaは,側面からの放熱は無視できるほど小さい.そのため,実際には基板への放熱と表面への放熱を考慮して設計する.PBGAの例を示した.


