システム・イン・パッケージに組み込まれるMEMS慣性デバイス ──小型,高精度を生かすMEMSデバイスのキラー・アプリ
●サーフェイス・マイクロマシーニングでセンサを作る
筆者ら(STMicroelectronics社)は,THELMA(Thick Epitaxial Layer for Micromotors and Accelerometers;マイクロモータと加速度計向けのエピタキシャル層)というサーフェイス・マイクロマシーニング技術を慣性センサに適用しています.
通常この加工技術では,最初にSiウェハの表面に「犠牲酸化層」と呼ばれる層を成長させます(図1).続いて,この層の固定素子を支持する位置と可動素子をアンカ止めにする位置にエッチングで穴をあけます.この後,この層の上にさらに厚いポリシリコン層をエピタキシャル成長させます.この第3の層に可動素子と固定素子の構造をエッチング加工します.最後に構造体の下にある犠牲酸化層を等方性エッチング注2で除去して,可動部品が自由に動作するようにします.素子構造の周囲の空間にガス(通常は乾燥したN2)を充てんし,共振周波数が湿度やガス密度の変化に影響されないようにします(図2).
MEMS技術は,Si半導体製造のために開発・改良されてきた実績のある製造技術を用いて,数百個のセンサをSiウェハ上に一度に製造できるという点で,非常に魅力的な技術です.しかも,各部品をウェハ上に隣り合わせに製造できるうえに,きわめてきめの細かい工程管理が可能です.ほかの製造方法による類似製品よりもはるかに精密,かつ高い精度を持つ製品を供給できます.
注2;結晶面の方向によらず同一の速度でエッチングする.ほかに異方性エッチングと呼ばれるものがあるが,これは結晶面の方向によってエッチング速度が大きく異なる.
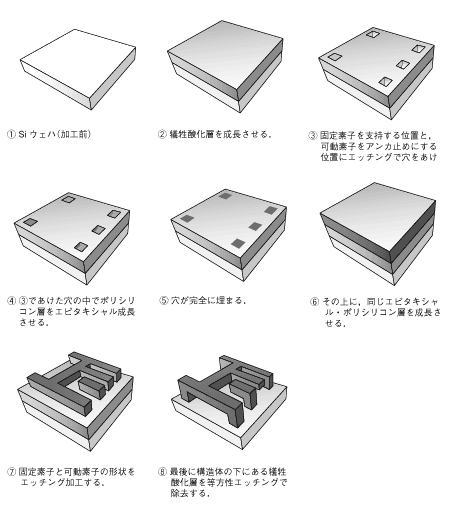
〔図1〕サーフェイス・マイクロマシーニング技術を用いた製造工程
慣性センサの製造工程を示す.二つ目の工程で成長させる層は「犠牲酸化層」と呼ばれるが,これは後に可動部が自由に動作できるように層のほとんどが取り除かれるためである.
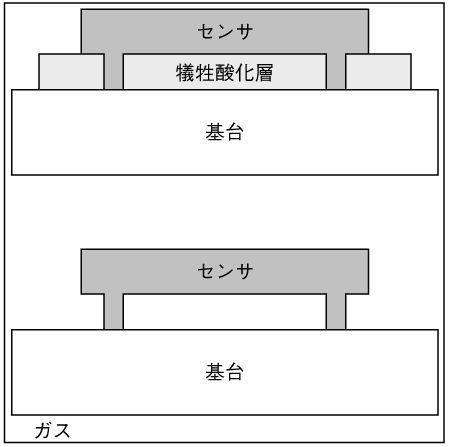
〔図2〕ガスの充てん
MEMS構造体の周辺のあいた空間はガスで満たす.通常,乾燥したN2を充てんして共振周波数が湿度やガス密度の変化に影響されないようにする.


