[ keyword: ボード ]
IBM,ビルドアップ配線板技術とフリップ・チップ実装技術を組み合わせたパッケージ技術を開発
ニュース 2002年7月16日
米国IBM社は,ビルドアップ配線板技術「SLC(Surface Laminar Circuit)」と,フリップ・チップ実装技術を組み合わせたパッケージ技術を開発した.SLCとは,プリント配線板の上に回路と感光性の絶縁層を順次重ねあわせるビルドアップ工法である.また,フリップ・チップ実装はLSIチップの機能面を下にして基板に直接取り付ける実装方法である,
本パッケージのビルドアップ層のビアは,絶縁層のフィルムに紫外線レーザを当てて形成する.ビアの直径は最小48μm.従来は,感光性樹脂を用いた写真法によってビアを形成していた.また,本パッケージはJEDEC(Joint Electron Devices Engineering Council)のJedec3に準拠している.
ピン・ピッチが最小212μmのパッケージを2002年第4四半期までに試作する予定である.パッケージに取り付けるフリップ・チップのピン・ピッチ(C4エリアのアレイ・ピッチ)は最小150μm.
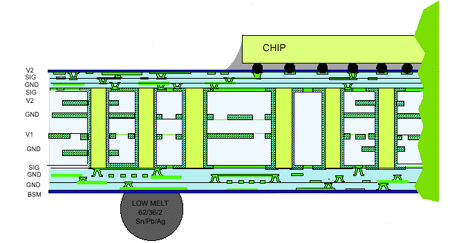
[図1] パッケージの構造図
■価格 |
■連絡先 |


